
材料・加工技術
6章:半導体パッケージング技術
6-4. 放熱設計(Thermal Management)
高性能パッケージは、電力密度が年々上がっており、電気より熱がボトルネックと言われるほど、熱設計が...

材料・加工技術
6章:半導体パッケージング技術
6-3. Fan-out / Fan-in パッケージ技術(WLP / FO-WLP)
半導体の小型化・薄型化・高性能化を支えるのが、Fan-in(WLP) と Fan-out(FO-...
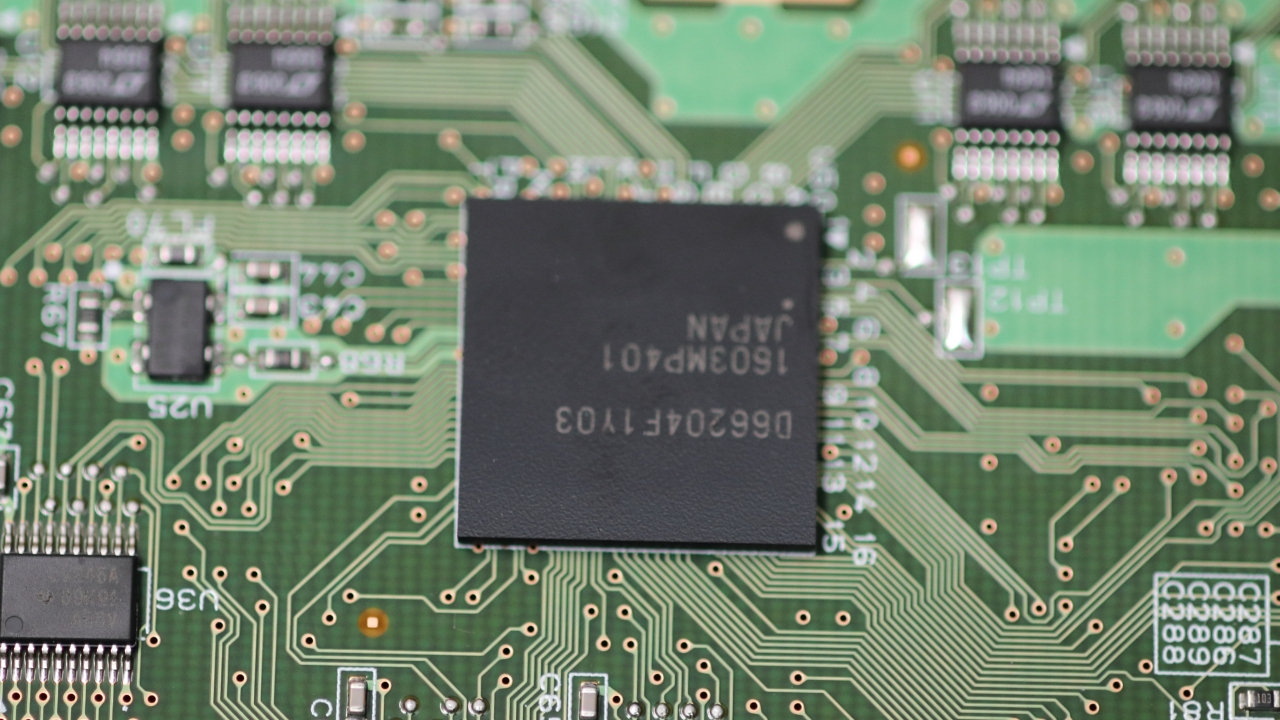
材料・加工技術
6章:半導体パッケージング技術
6-2. フリップチップ(Flip Chip)実装技術
フリップチップは、半導体チップを反転(Flip)し、バンプ(はんだ / Cuピラー)で基板に直接...

材料・加工技術
6章:半導体パッケージング技術
6-1. ワイヤボンディング技術(Wire Bonding)
ワイヤボンディングは、半導体チップとパッケージ基板を極細の金属ワイヤで接続する技術であり、パッケ...









